DAF


반도체 Package의 적층화 및 박형화를 위한 초박형 필름 접착소재
DAF(Die Attach Film)은 반도체 Package 공정에서 반도체 칩과 회로기판 또는 칩 간 연결에 사용되는 초박형 필름 접착제입니다. 웨이퍼를 개별 칩으로 분리시 웨이퍼를 지지하는 다이싱 테이프(Dicing Tape)와 반도체 칩을 기판에 접착하는 다이 본딩 테이프(Die Bonding Tape)가 일체화된 형태로 Package 공정을 간소화할 수 있습니다. 특히 플래시 메모리 등 고집적 반도체의 후공정에서 필수적으로 사용되는 소재이며, 탁월한 신뢰성 및 용이한 공정성으로 반도체 Package의 적층화 및 박형화를 가능하게 합니다.
제품용도
제품 기능 및 구조
• 균일한 두께 제어를 통해 안정적인 접합 품질 확보
• 우수한 매립 특성 및 Die Attach 경화 후 Void-free 접합으로 신뢰성 향상
• 강력한 접착력으로 다양한 기판 및 칩에 대한 고신뢰성 접합 가능
• 우수한 내열성 및 신뢰성으로 고온 공정 및 열 사이클 환경에 대응
• Easy Pick-up 및 우수한 공정성
• Blade 및 Laser Dicing 공정 호환 가능
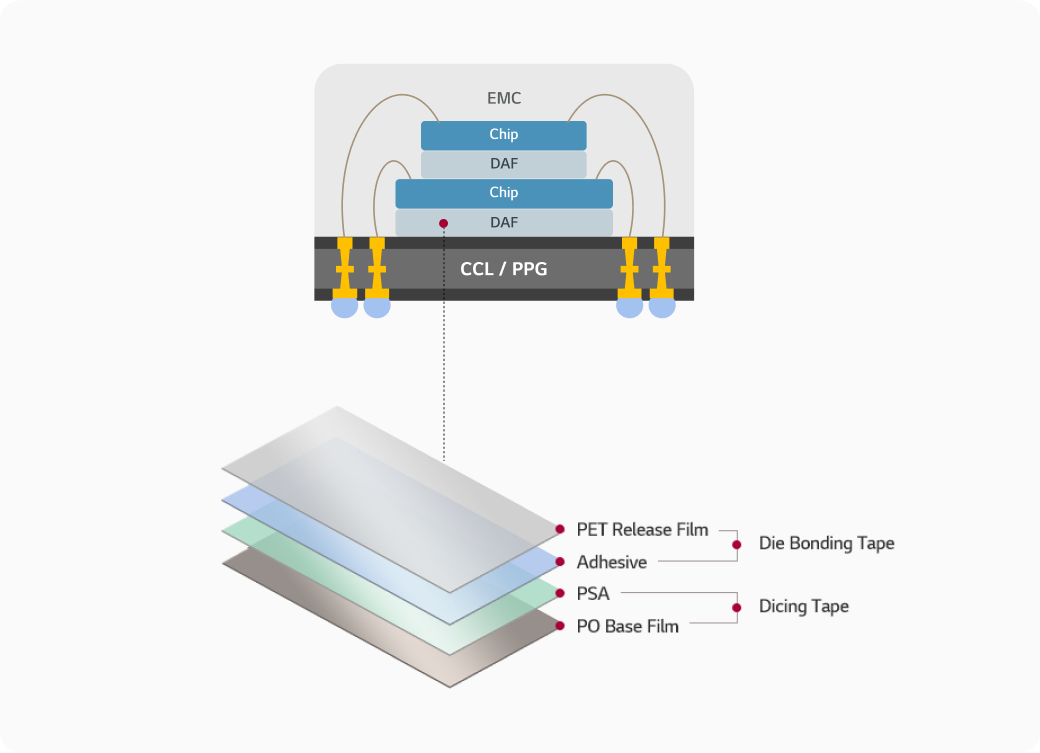
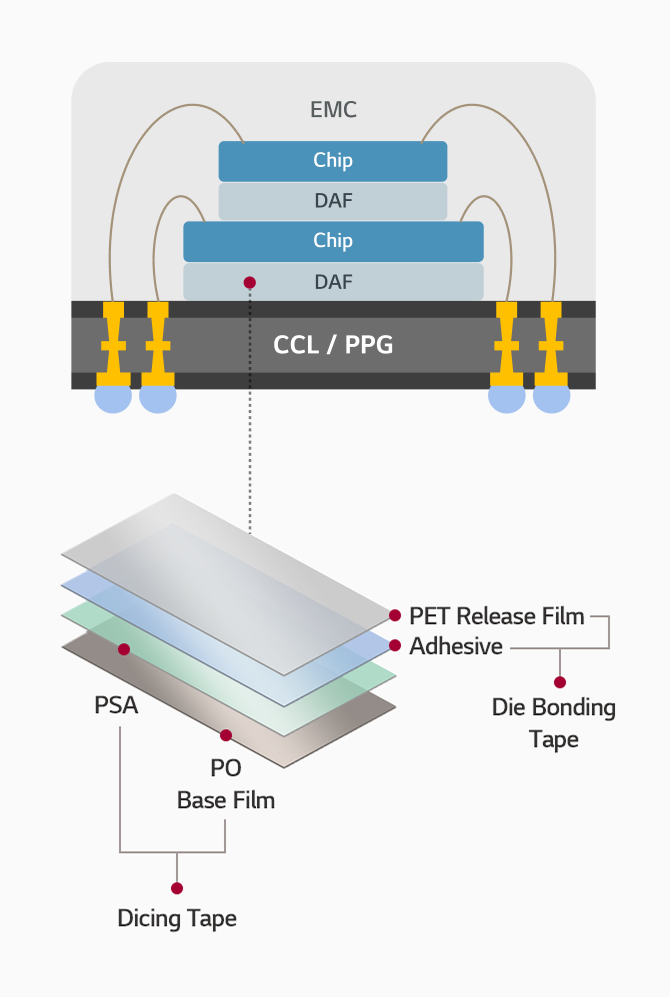
DAF 제조 공정